HBM研究框架:突破“内存墙”,封装新突破


HBM突破“内存墙”,实现高带宽高容量,成为Al芯片最强辅助,我们认为HBM将持续迭代,1/0口数量以及单1/0口速率将逐渐提升,HBM3以及HBM3e逐渐成为Al服务器主流配置,且产品周期相对较长,单颗容量及配置颗数逐步增加,预计HBM4于2026年发布。2024年全球HBM市场有望超百亿美元,市场空间足,国产供应链加速配套。
当前HBM采用“TSV+Bumping”+TCB键合方式堆叠,但随着堆叠层数的增加散热效率很差,TCB不再满足需求,海力士率先引入MR-MUF回归大规模回流焊工艺,芯片之间用液态环氧模塑料作为填充材料,导热率比TC-NCF中的非导电薄膜高很多,但海力士也预计HBM4会引入混合键合Hybrid Bonding方案,取消互连凸块。
1、HBM—突破“内存墙”

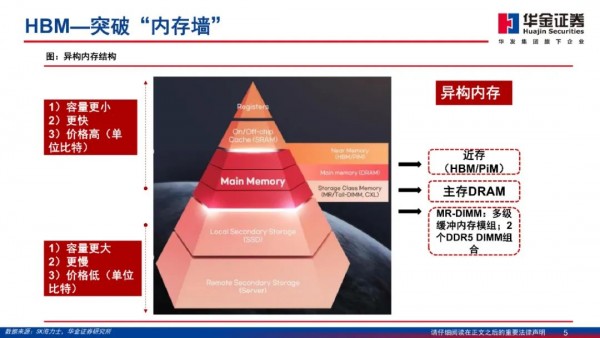
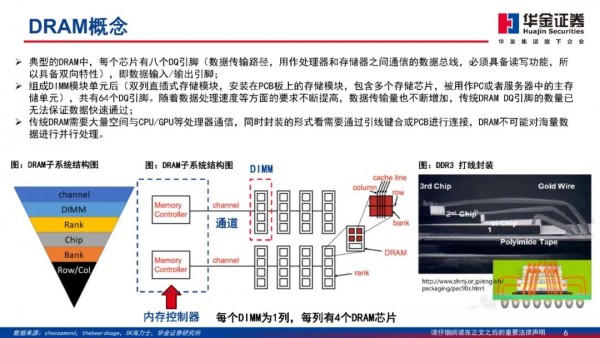
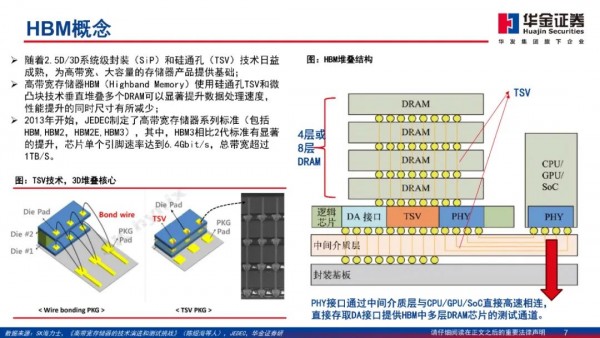


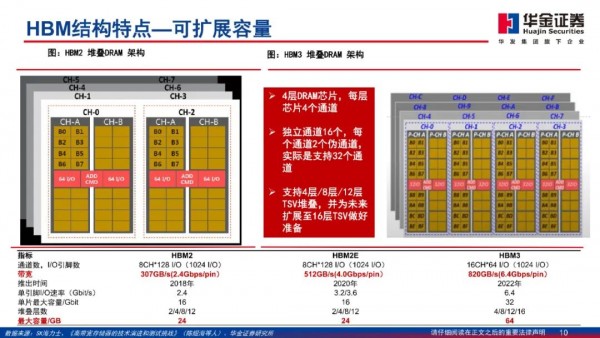

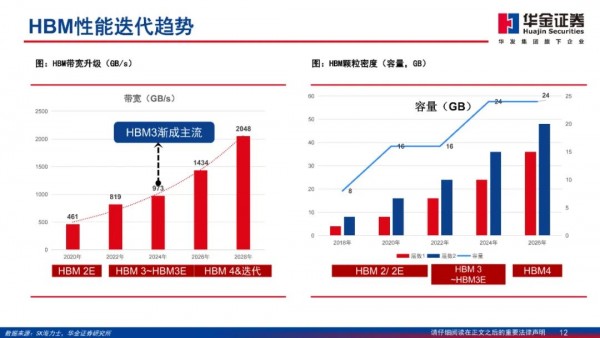
2、Al算力快速迭代,HBM为最强辅助


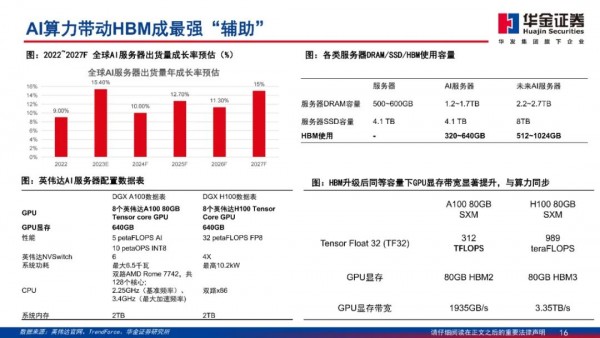


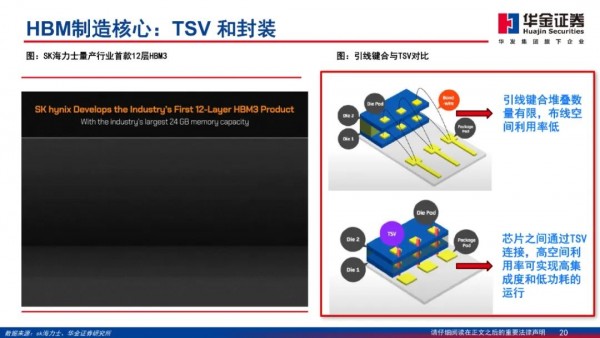
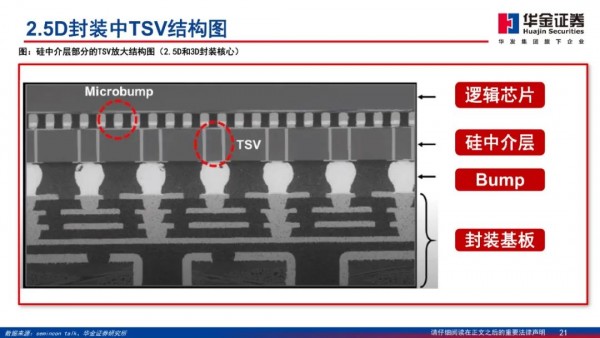
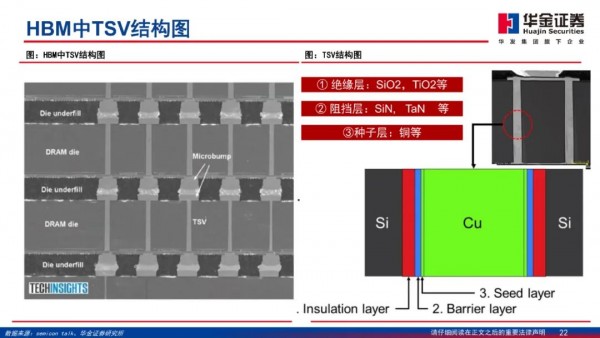

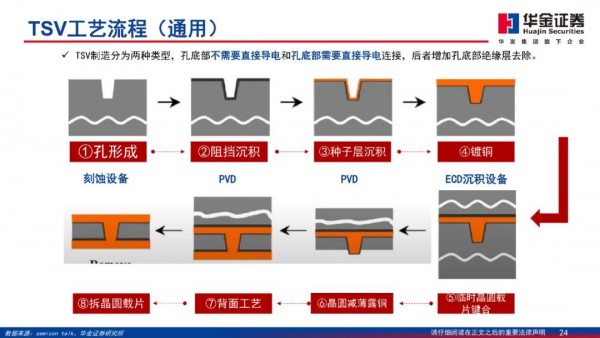
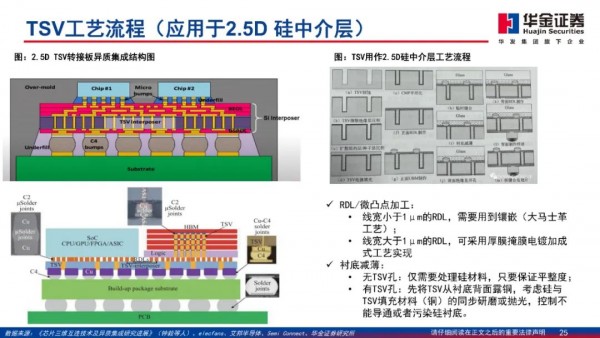
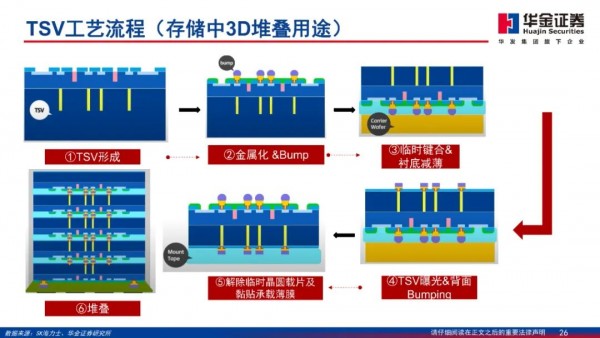
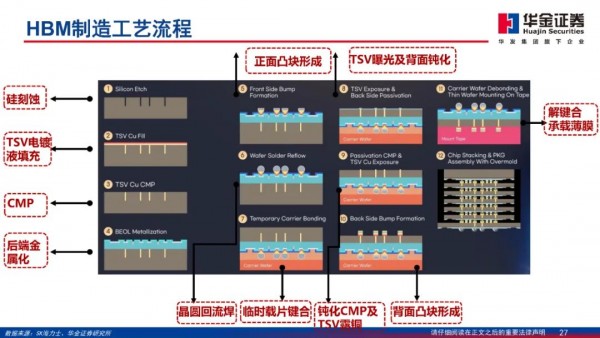


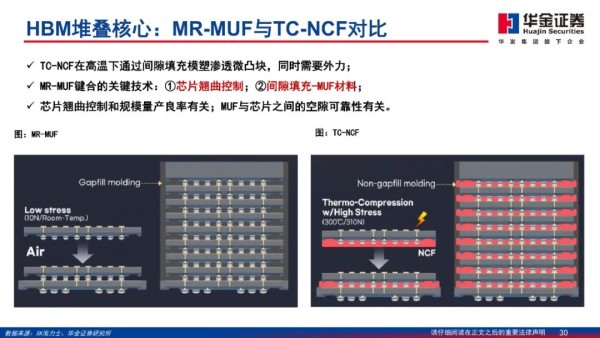
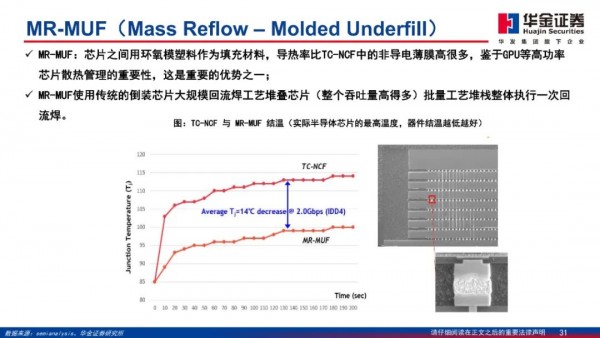
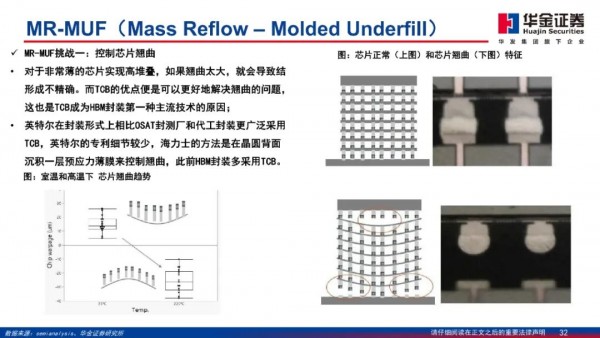
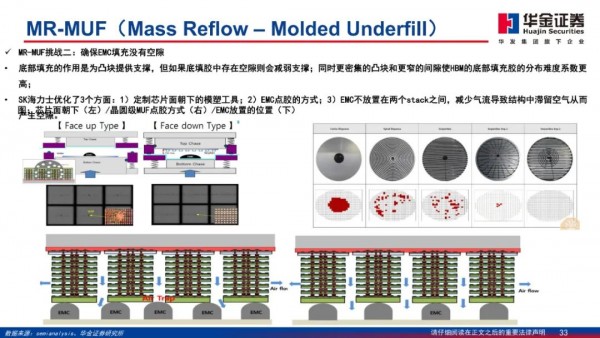
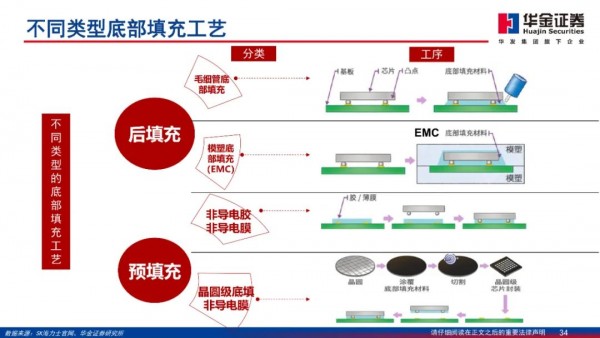
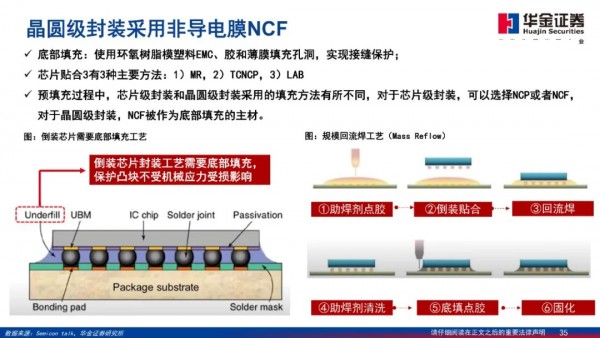

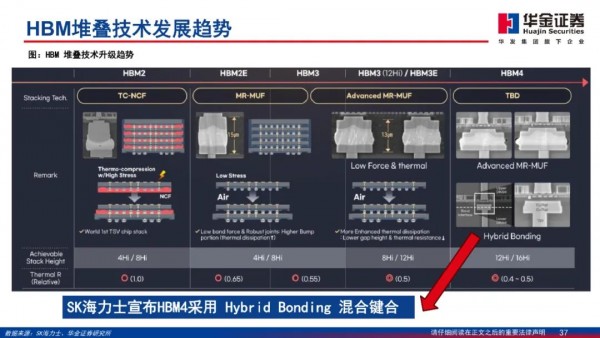

好文章,需要你的鼓励
Glean年收入突破3亿美元,削减AI成本成核心卖点
企业AI搜索公司Glean宣布年度经常性收入(ARR)达3亿美元,较15个月前的1亿美元增长三倍。尽管谷歌、微软、OpenAI等科技巨头纷纷入局企业AI搜索市场,Glean凭借"上下文图谱"技术深度理解企业业务需求,并帮助客户显著降低AI计算成本。该公司提供按用量计费和混合定价两种模式,客户涵盖Databricks、Reddit、Pinterest及三星等企业。Glean上轮融资后估值达72亿美元。
香港中文大学与MiniMax联手破解AI图像描述的“说多错多、说少漏多“困局
香港中文大学与MiniMax提出ClaimDiff-RL框架,将图像描述的AI训练从整体打分升级为逐条核查,有效解决了传统方式导致AI"少说保平安"的问题,同时在多项基准测试上超越Gemini-3-Pro-Preview。
蓝色起源“新格伦“火箭在佛罗里达测试中发生爆炸
杰夫·贝索斯旗下的蓝色起源公司在佛罗里达卡纳维拉尔角进行静态点火测试时,新格伦重型火箭发生爆炸。这是美国历史上最大规模的火箭爆炸之一,也是蓝色起源公司遭遇的最严重失败。所有人员安全,但该事故可能导致新格伦火箭项目长期暂停。此前该火箭已成功完成三次发射,并实现了助推器回收和重复使用。
NTU、HKU等多所顶校联手,让AI同时“多角度看片“——视频理解的并行探针革命
ParaVT是一个由南洋理工等多校联合提出的并行视频工具调用框架,通过让AI同时分析多段视频并引入PARA-GRPO算法解决训练中的格式崩溃与工具跳过问题,在六项长视频理解测试中平均提升约7.9%。







