HBM研究框架:突破“内存墙”,封装新突破


HBM突破“内存墙”,实现高带宽高容量,成为Al芯片最强辅助,我们认为HBM将持续迭代,1/0口数量以及单1/0口速率将逐渐提升,HBM3以及HBM3e逐渐成为Al服务器主流配置,且产品周期相对较长,单颗容量及配置颗数逐步增加,预计HBM4于2026年发布。2024年全球HBM市场有望超百亿美元,市场空间足,国产供应链加速配套。
当前HBM采用“TSV+Bumping”+TCB键合方式堆叠,但随着堆叠层数的增加散热效率很差,TCB不再满足需求,海力士率先引入MR-MUF回归大规模回流焊工艺,芯片之间用液态环氧模塑料作为填充材料,导热率比TC-NCF中的非导电薄膜高很多,但海力士也预计HBM4会引入混合键合Hybrid Bonding方案,取消互连凸块。
1、HBM—突破“内存墙”

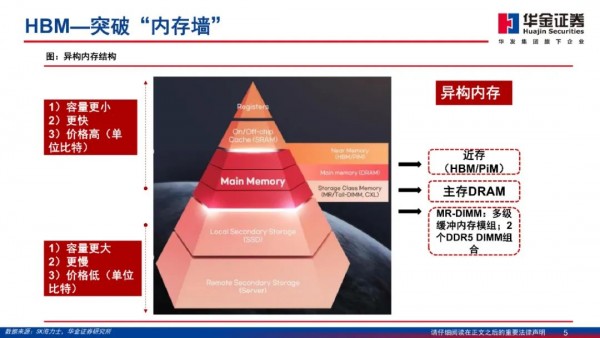
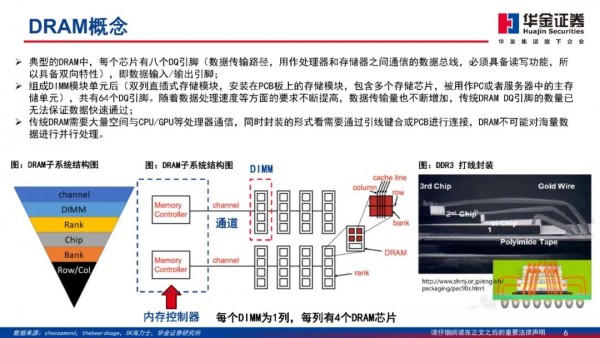
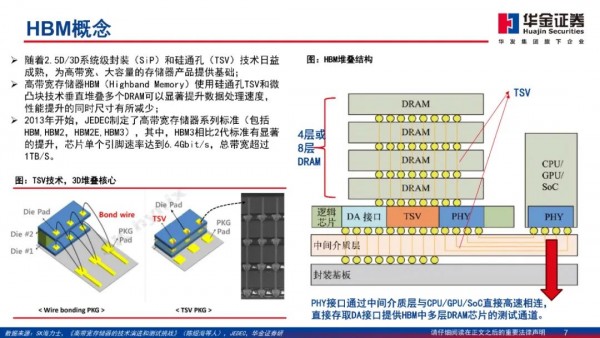


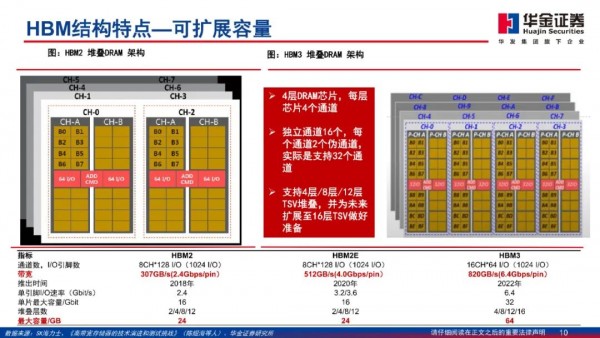

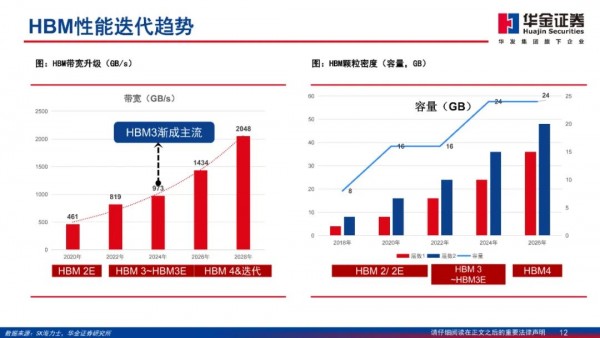
2、Al算力快速迭代,HBM为最强辅助


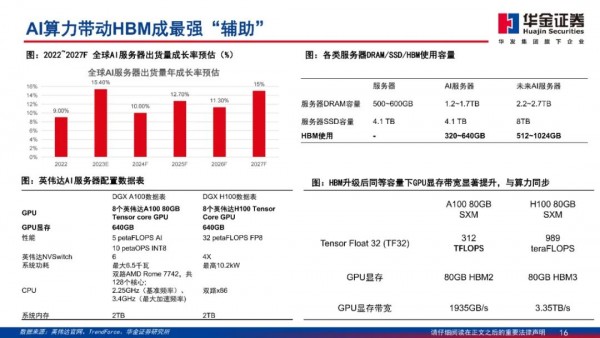


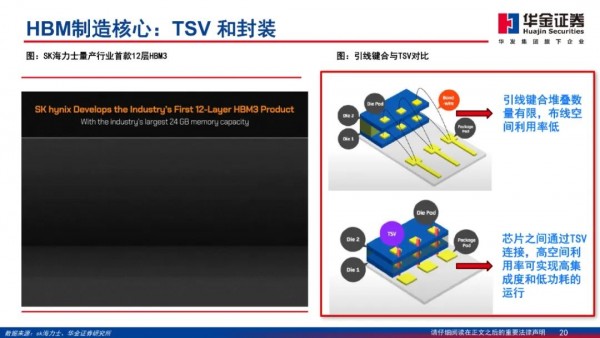
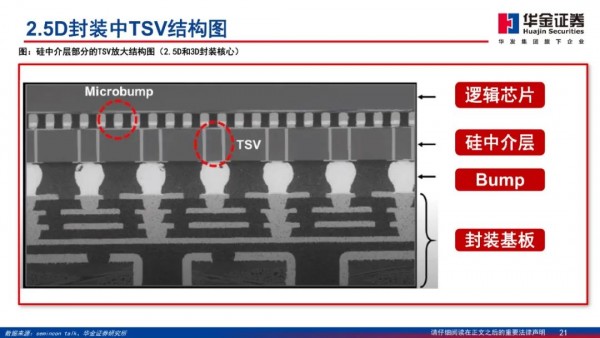
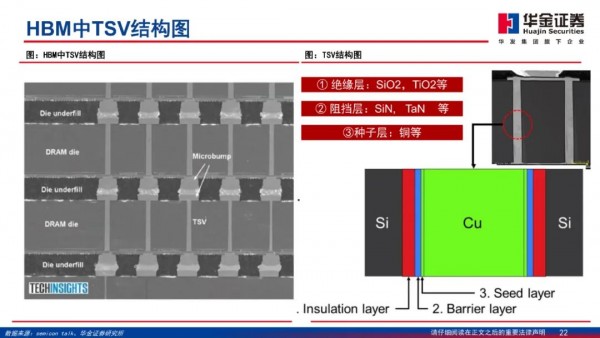

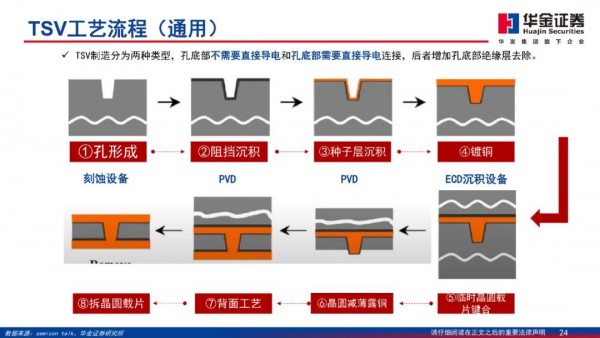
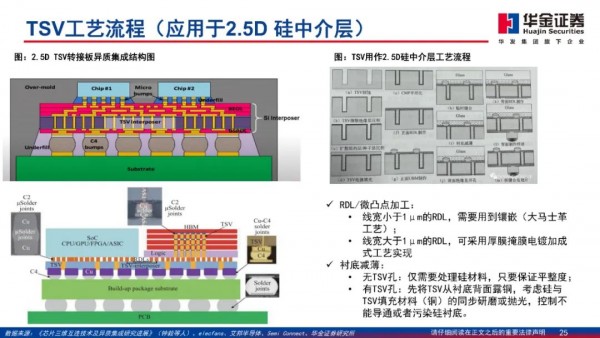
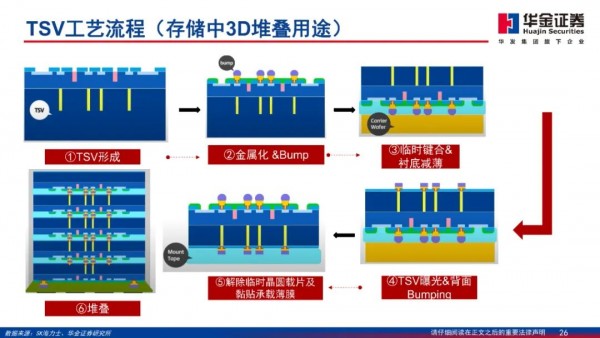
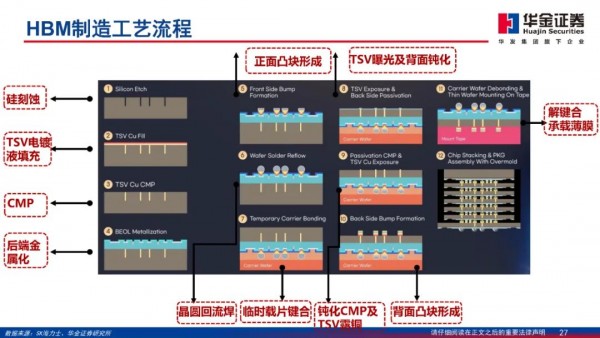


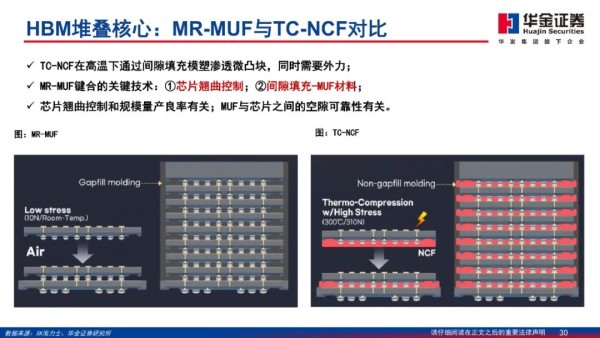
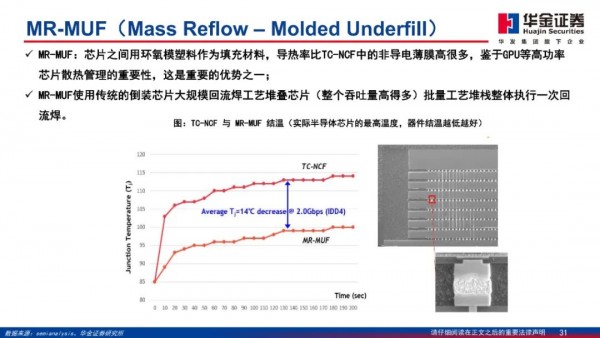
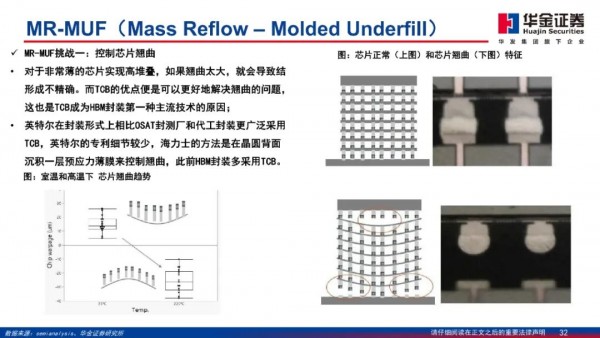
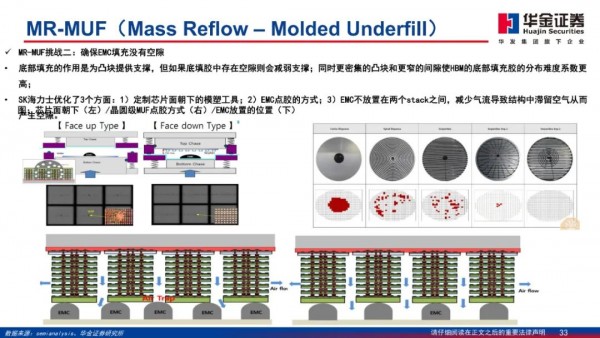
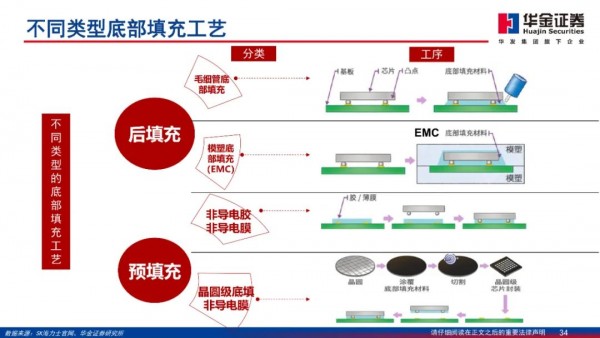
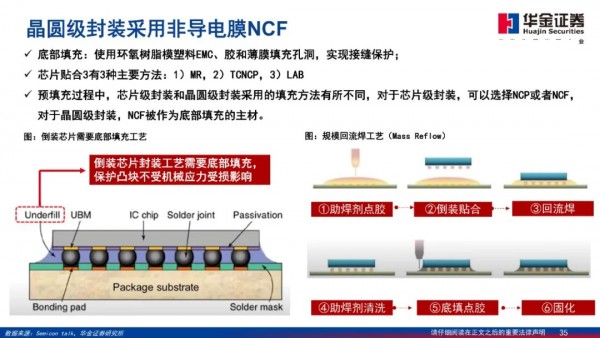

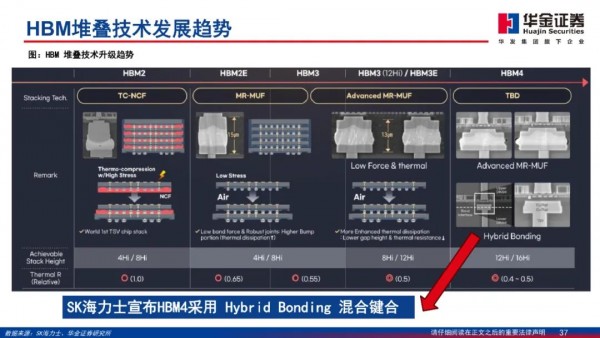

好文章,需要你的鼓励
让AI记住房间每个角落:悉尼大学团队如何让视频生成拥有“空间记忆“
悉尼大学和微软研究院联合团队开发出名为Spatia的创新视频生成系统,通过维护3D点云"空间记忆"解决了AI视频生成中的长期一致性难题。该系统采用动静分离机制,将静态场景保存为持久记忆,同时生成动态内容,支持精确相机控制和交互式3D编辑,在多项基准测试中表现优异。
西班牙病毒如何将谷歌带到马拉加
33年后,贝尔纳多·金特罗决定寻找改变他人生的那个人——创造马拉加病毒的匿名程序员。这个相对无害的病毒激发了金特罗对网络安全的热情,促使他创立了VirusTotal公司,该公司于2012年被谷歌收购。这次收购将谷歌的欧洲网络安全中心带到了马拉加,使这座西班牙城市转变为科技中心。通过深入研究病毒代码和媒体寻人,金特罗最终发现病毒创造者是已故的安东尼奥·恩里克·阿斯托尔加。
马里兰大学突破性发现:AI推理过程终于有了“身体检查“——ThinkARM框架揭开大型语言模型思维奥秘
马里兰大学研究团队开发ThinkARM框架,首次系统分析AI推理过程。通过将思维分解为八种模式,发现AI存在三阶段推理节律,推理型与传统AI思维模式差异显著。研究揭示探索模式与正确性关联,不同效率优化方法对思维结构影响各异。这为AI系统诊断、改进提供新工具。







